현재 수익률
9%작성시 주가
30,900 KRW25.01.24 기준
목표가
60,000 KRW94%투자의견
매수투자기간
2025/01~2025/07
컨센서스

24년 4월 고려대 가치투자동아리 컨센 목표주가 89,200원

부산대 SMP 동아리 목표주가 62,900원

버틀러에서 한눈에 볼 수 있는 증권사별 목표주가 45,000~65,000원을 종합
평균 컨센 65,550원
이는 25년 EUV블랭크마스크와 펠리클의 매출이 반영된다는 기준의 컨센
결론을 먼저 도출하자면
에스앤에스텍의 미래 주가 방향은 EUV블랭크마스크와 EUV펠리클에 달려있음
25년 1월 15일 기준 시총 6,264억
24년 E영익 320~340억. 순익 300~320억 기준 현 시총이 결코 저평가라고 할 수 없음
25년 E영익이 430~630억이나 24년초 레포트 컨센이 높게 형성되어있어 그나마 최근 레포트인 24년 7월 레포트를 위주로 보면 430억 수준. 이 또한 영업이익일 뿐이라 시총 6천억은 여전히 고밸류일 수도 있음
하지만 국내 유일의 EUV블랭크마스크와 펠리클을 양산하고 매출 인식이 되기 시작한다면 해당 종목은 그 이상의 평가를 받을 수 있을 것이라고 생각

챠트상으로 봐도 현재 자리는 하방이 어느 정도 확실히 형성되어있어 리스크를 감수하고 한번 진입해볼만한 자리
(1월 7일부터 작성 시작했는데 26천원대였던 주가는 소폭 상승해서 30,900원)
어떤 이유에서든 19,000원이 깨진다면 무조건 손절이라고 생각했지만 무색하게도 쭉쭉 오름
기술적인 상방은 단기 38,000원. 장기 50,000원까지는 열려있다고 생각함

네이버의 매물분석도가 얼마나 정확한 데이터인지는 모르겠으나
현 가격보다 높은 가격에 71%가 포진하고 있음
물린 사람이 많기 때문에 올라갈 여지가 있다고 생각할 수도 있으나 물린 사람이 많은 만큼 올라갈때마다 본전 욕구에 엄청나게 팔아될 수도 있는거임
그 욕구들을 다 이겨내고 올라가려면 결국 확실한 호재성 기사가 나와줘야한다고 생각
헛소리는 여기까지 지껄이고 이제 에스앤에스텍이 투자가치가 있는지 확인해보고자 함
사업의 개요
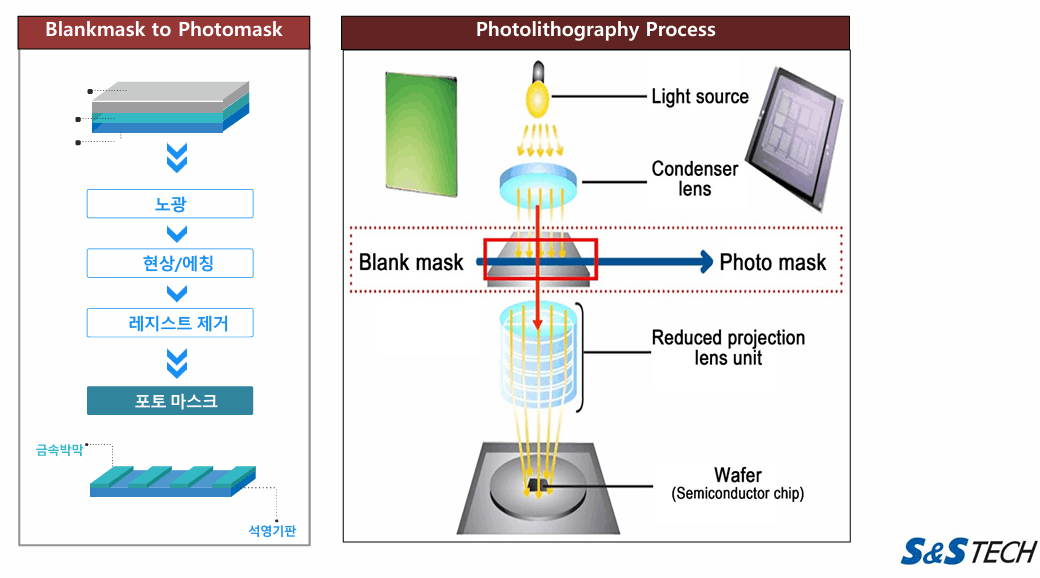
에스앤에스텍은 반도체 및 디스플레이(FPD) 제조에 사용되는 블랭크마스크 제조 및 판매사업 영위
블랭크마스크는 반도체 노광공정에 반드시 필요한 부품
2002년 국내 최초로 반도체용 블랭크마스크 개발
2005년 국내 최초로 디스플레이용 블랭크마스크 개발
블랭크마스크는 특성 자체가 '재료적' 성격을 가짐에 따라 물질, 구조 등이 결정되면 변화가 어려운 산업적 특성을 지님
블랭크마스크는 웨이퍼에 회로의 그림을 그릴 수 있게 도와주는 도화지 역할로 여기에 패턴을 형상화하고 나면 포토마스크가 됨
2020년 삼성전자로부터 지분 8%(659억) 투자 유치 - EUV 블랭크마스크와 펠리클 연구지원의 일환

버틀러
에스앤에스텍은 지난 5년간 연평균 15.5%에 달하는 매출 성장률을 기록하고 있음
아직 EUV 블랭크마스크와 펠리클이 양산되기 전임에도 불구하고 반도체 수요 증가에 따라 기존 블랭크마스크와 펠리클 수요는 지속 상승 중이며, 미국의 중국 제재에 따라 중국향 매출 비중이 높을 것으로 파악

버틀러
수출금액은 23년부터 꾸준히 성장 중이며 최근들어 더욱 급격한 상승 중
블랭크마스크의 단가 자체가 23년부터 크게 상승하면서 수출중량 대비 수출금액이 매우 크게 상승한 것을 알 수 있음.
FPD블랭크마스크
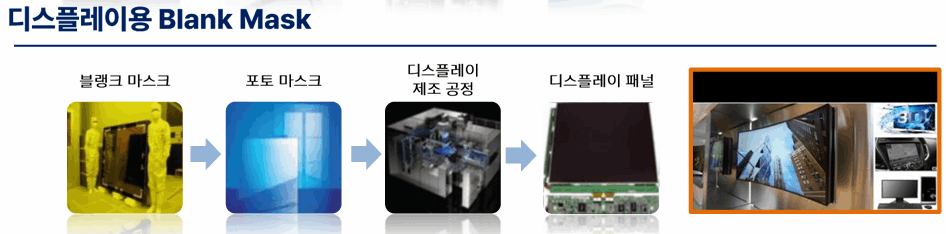
TFT-LCD와 같은 디스플레이 액정 소자 제조를 위한 포토마스크 원재료
반도체용 대비 사이즈가 큰 관계로 대형 블랭크마스크라고도 불림
FPD용 블랭크마스크를 통해 제작된 포토마스크로 스마트폰, 태블릿PC, 컴퓨터모니터, TV와 같은 디스플레이 패널 제작이 가능
사이즈가 큰 만큼 단가가 쎄서 매출 효자 역할을 함
DUV(심자외선) 블랭크마스크

시장의 수요는 더욱더 고집적화된 반도체를 요구하는 중
광원의 파장은 점차 짧아져 회로폭 10nm(DUV ArF)까지 도달
DUV 기술로 도달할 수 있는 영역은 회로폭 10nm가 한계
EUV(Extream Ultraviolet) 블랭크마스크
EUV용 블랭크마스크는 EUV 노광 공정에서 웨이퍼에 회로를 새기는 데 활용되는 패턴 마스크의 원판으로 나노미터 수준의 얇은 다층막(멀티 레이어) 위에 흡수체인 기반 합금을 다시 적층하는 과정을 거쳐 제작
광원 파장의 발전 순서
G라인(436nm) → I라인(365nm) → KrF(243nm) → ArF(193nm) → IArF(134nm) → EUV(13.5nm)
EUV 기술은 기존 사용하던 ArF(193nm)광원의 파장보다 약 15배정도 짧은 13.5nm길이의 파장을 사용
해상력 보정 기술없이도 10nm이하 선폭까지 공정이 가능한 고집적회로 생산용 노광 기술

EUV에 한번쯤이라도 관심가져본 사람이라면 봤을 이미지
EUV 노광장비는 DUV처럼 렌즈를 사용할 수 없음. EUV는 고체, 액체뿐만 아니라 공기와 같은 기체에서도 쉽게 흡수되기 때문에 렌즈를 사용하면 전부 흡수되어버림. 그래서 위 이미지와 같이 미러를 사용하여 빛을 반사시킴
마스크도 투과형 마스크는 흡수되어버리기 때문에 Mo(몰리브덴)/Si(실리콘) 의 다층박막으로 구성된 반사형 마스크를 사용. 이렇게 서로 다른 광학적 특성을 가진 층을 80번 쌓아야 EUV 빛을 약 60% 정도 반사할 수 있음
EUV 노광장비는 ASML이 독점하고 있는데 장비 안에 들어가는 부품 중 미러가 가장 비싼 것으로 추측
ASML의 EUV 장비에 들어가는 미러는 독일의 자이스(ZEISS)에서 제조(독점)
한 장비당 약 10개의 미러가 사용되며 장비 가격의 30% 정도를 차지할 것으로 추측됨(장비 1대 약 5,000억)
이 10개의 미러 중 한개라도 줄이게 되면 빛 손실이 줄어 시스템의 효율성과 성능이 향상될 수 있음
EUV 노광 장비를 만드는 기술은 넘사벽 수준이라고 하는데 그 이유 중 가장 간단하게 한가지만 이야기해보자면,
High NA EUV를 소개합니다! | ASML Korea
Behind this Door: Learn about EUV, Intel’s Most Precise, Complex Machine
위 영상을 보면 주석이 한방울 한방울 떨어질때 마다 고출력 레이저가 주석 방울을 타격하면 주석방울이 순간 폭발 기화하면서 플라즈마상태가 되어 극자외선 EUV를 방출하게 되는 원리임
말이 쉽지. 이 주석방울이 초당 50,000회가 떨어지고 각각의 주석방울을 레이저로 두번씩이나 정교하게 맞추는 기술의 장비임. 놀라운건 이건 그저 EUV 극자외선이 나오게 하기 위한 시작일 뿐이라는 것임
(미러마다 빛의 손실율이 다르기에)미러마다 소재가 다 다르고 상황에 따라 여러가지 물질을 섞어서 사용
삼성메모리 D램
1Z EUV마스크 1개 사용
1A EUV마스크 5개 사용
1B EUV마스크 8개이상 추정
DUV는 포토마스크를 통과하여 웨이퍼에 회로 패턴을 새기지만 EUV는 극자외선의 짧은 파장의 빛을 반사시켜 회로 패턴을 새김으로써 7nm 이하의 미세공정까지 가능함
EUV는 DUV 대비 결함 허용 기준이 두배이상 높아 개발 난이도 높음
25년 연간 EUV 노광장비 전체 출하량의 30%이상을 메모리 부문이 차지할 것으로 예상
SK하이닉스 올해 10나노급 6세대 D램 공정 전환 투자 본격화할 전망
에스앤에스텍은 투과율 90%이상의 EUV 마스크를 개발 완료하였으며 양산 준비 중에 있음
EUV레이어
삼성 2018년 7nm 양산에 EUV 공정 도입 후 5nm, 3nm 공정에 적용 레이어 증가
반도체 미세화 영향으로 EUV레이어는 지속 증가
2nm 반도체 생산에 필요한 EUV레이어는 3nm 대비 30%이상 증가
하이 NA EUV
EUV 마스크는 최소 수십만번이상 노광 과정을 반복하기 때문에 열변형이 심화됨
EUV 리소그래피 장비에 도입하려고하는 NA(High Numerical Aperture)시스템에서는 마스크 그림자 효과 및 3D효과로 인해 새로운 구조 및 재료의 마스크가 필요하지만 EUV 흡수 및 열팽창 계수 등이 기존 EUV마스크보다 크기 때문에 기존에 발견하지 못했던 열변형 문제 발생 가능성 있음
※리소그래피 : 석판 인쇄술. 다른 말로 노광공정
※ NA : 개구수를 의미. 광학계의 크기. 렌즈의 직경
EUV 리소그래피는 13.5나노미터의 극자외선을 사용해 반도체 웨이퍼에 미세한 회로 패턴을 새기는 기술
기존 노광장비로는 불가능했던 10나노미터 이하의 미세회로 구현 가능
블랭크마스크 시장 점유율


반도체 블랭크마스크는 Hoya 40%, AGC 30% 점유
FPD 블랭크마스크는 에스앤에스텍이 Hoya와 34% 점유
글로벌리 전체 DUV 및 EUV블랭크마스크 시장은 Hoya가 70%로 압도적인 점유 중
중국 시장 내 반도체 블랭크마스크는 에스앤에스텍이 40%로 Hoya에 앞서고 있음
에스앤에스텍의 중국향 매출은 지속적으로 상승 중에 있음
독보적인 ASML
ASML은 EUV 장비를 1년에 약 45대정도 생산하는 독점업체
삼성전자를 비롯하여 SK하이닉스, TSMC, 인텔 등 사려는 업체는 줄을 서 있음
High NA 제품 1대당 가격은 5,000억 수준. 이 비싼 장비를 쓸 수 밖에 없는 이유?
Low NA 장비 가격이 3,500억. 미세화 공정을 위해 더블패터닝, 트리플패터닝을 하려면 2대, 3대의 장비가 필요한데 그럼 가격은 7,000억~1조를 넘어감
차라리 5,000억짜리 High NA 장비를 사는게 더 경제적
다른 업체들이 ASML의 장비를 흉내도 못내는 이유는 ASML은 2Way 스캔 방식을 사용
한쪽에서 웨이퍼를 노광하기 전 준비하고 있고 다른 쪽에서 준비된 웨이퍼를 노광하는 기술
다른 회사의 장비들은 웨이퍼를 트랙에 넣고 노광까지 진행하기 때문에 공정시간이 늘어짐
펠리클
EUV 펠리클을 일반적으로 보호필름이라고 표현하지만 실제로는 폴리실리콘 소재 즉, 투명한 유리임
폴리실리콘은 주로 태양광 판을 제작하는데 사용되는 소재임
펠리클의 가장 큰 문제점 중 하나는 열을 견디는 내구성이 약하다는 것이고 펠리클이 EUV장비 내에서 깨지기라도 한다면 모든 장비를 멈추고 장비 내부 청소를 해야하는 막대한 손실이 발생하기 때문에 엄청난 기술력을 요구하는 부품이라고 할 수 있음
기존 ArF 펠리클의 투과도는 거의 99.9%
하지만 EUV펠리클은 아무리 잘 만들어도 현재 기술로는 90%를 넘기는 수준
(이 말은 즉 10% 정도의 빛이 펠리클에 흡수되어 열로 변환된다는 뜻)
즉, 출력이 600W라고 보면 EUV펠리클이 흡수하는 열이 60W까지 올라간다는 뜻
즉 출력이 높아질수록 펠리클은 이 열을 흡수하고 견딜 수 있는 내구성이 중요
열 흡수를 해결하는 두가지의 방법
- 투과도를 95% 이상으로 끌어올려 흡수율을 낮추는 방법
- 올라가는 온도를 견딜 수 있는 소재를 개발하는 방법
현재 시장은 투과도를 높이는 방법으로 방향을 잡고 있음
현재 펠리클의 두께는 약 30나노미터 수준으로 이는 집에서 음식을 덮는데 사용하는 랩을 더욱 얇게 만들어서 대학교 캠퍼스를 덮을 수 있는 수준으로 더 얇게 만드는 기술까지 발전해있다고 함
이렇게 얇으면서도 몇백도의 온도에서 녹지않고 빛의 흡수를 줄이는 소재를 만들어야 함
그래서 나온 것이 카본 나노튜브(CNT)기반 펠리클
카본 나노튜브(CNT)기반 펠리클 : EUV펠리클의 투과도는 90% 수준으로 출력이 높아지면 펠리클이 흡수하는 열도 증가하여 견디가 어려워짐. 이를 해결하기 위해 카본 CNT 펠리클이 주목받고있음
카본은 그 성질대로 기존의 필름 형태가 아닌 구멍이 듬성듬성 뚫린 형태의 구조가 됨. 나노 형태이기에 구멍이 우리가 생각할 수 없는 수준으로 작아 빛의 투과율도 높이면서 펠리클의 기능도 유지할 수 있음
아직 상용화는 불가하지만 카본 나노튜브를 사용하여 투과도를 96~97%까지 실현함. 왜 사용이 불가한지는 아래쪽 단점에서 나옴
(벨기에 소재의 반도체 연구소 IMEC에서 시작. 그 이전 한양대에서 연구를 진행. 한양대 연구생이들이 IMEC으로 가면서 프로젝트가 발전했으며 지금은 인텔에서 그 프로젝트를 담당하고 있다고 함)
현재 CNT펠리클에서 가장 앞서고 있는 회사는 핀란드의 카나투라고 함
카본 나노튜브 펠리클은 가장 큰 문제점이 하나 있음
마스크 주변의 스캐너 구조는 하이드로젠(수소) 플라스마 환경이 조성되어있음
수소 플라스마는 카본을 공격하는 특성을 가지고 있어 CNT펠리클이 처음에는 잘 작동하다가 없어져버림
펠리클을 보호하는 코팅을 해야하는데 아직까지 완벽한 코팅을 찾지 못했다고 함
수소에서 나오는 H+이온은 과학적으로 막을 방법이 없다고 함
그럼에도 불구하고 CNT로 펠리클을 만드는 것이 가장 실용적인 방법이라고 함
왜냐하면 2주정도 견딜 수 있으면 충분하다고 업계에서 보고 있기 때문
TSMC는 EUV 공정에 펠리클을 100% 사용 중
삼성은 안쓰고 있다기 보다 못쓰고 있다고 하는데 소량은 사용 중이라는 기사도 있음
펠리클을 사용하면 투과도 90%. 빛 반사 2번되면 20%의 손실 발생. 즉 생산성 20% 하락
TSMC는 그럼에도 왜 사용? 여러대의 장비로 커버 가능하기 때문에 안전하게 생산. 삼성은 NO
EUV장비 향후 TSMC 약 160대, 삼성전자 약 60대, SK하이닉스 약 10대, 인텔 약 10대
EUV펠리클 제작은 현재 미쓰이가 독점적
미쓰이화학은 1984년부터 펠리클을 출시하여 반도체의 소형화에 맞춰 품질을 개선해왔음
ASML의 라이선스를 받은 캐나다 업체의 필름을 미쓰이가 가져다가 프레임에 부착해서 제작
TSMC는 자체 생산 사용하고 있다고 알려져있으나 투과도가 90% 수준이라고...
펠리클 가격 장당 약 3,000만원
High NA로 가면 펠리클 가격은 더욱 비싸질 것으로 예상
(캐나다 텔레다인이 처음 샘플을 팔 때 장당 약 1억이었다고 함)

24년 5월 31일 기사에 따르면,
24년 5월 28일, 미쓰이 화학은 EUV리소그래피용 CNT펠리클 생산 시설 설치 결정
이 시설은 연간 5,000여개의 CNT펠리클을 생산할 것으로 보임
현재 EUV펠리클이 3,000만원인데 CNT펠리클은 최소 5,000만원이상 할 것으로 보이고 연간 5,000장을 생산한다고 하면 2,500억원 수준아닐까 추측
25년 12월 완공 예정
경쟁사 에프에스티
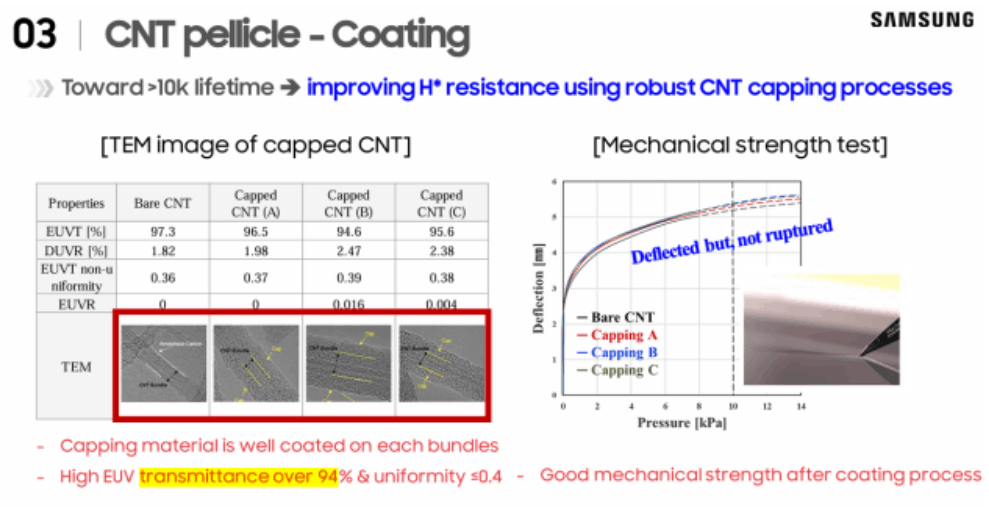
경쟁사라고 하기에는 조금 애매
에프에스티는 펠리클 생산기업으로 국내 펠리클 시장의 약 80%이상을 차지
에스앤에스텍이 에프에스티가 선점하고 있는 시장을 진입하고자 한다고 보는게 맞음
삼성전자는 21년 기술 개발 협력을 위해 에프에스티에 430억 투자
24년 10월 기사에 따르면, 삼성전자가 에프에스티와 함께 개발한 CNT펠리클이 EUV 빛을 94%이상 투과시키는데 성공했다고 함. 이른바 캐핑CNT펠리클로 수명을 20배정도 늘렸다고 소개함
삼성파운드리는 현재 미쓰이화학의 펠리클을 소량 적용 중이라고 함.

에스앤에스텍은 23년 사업보고서에 위와 같이 밝히고 있으며 24년 7월 기사에 따르면 500W 펠리클로 개발 완료하고 양산 준비 중에 있다고 함
에스앤에스텍의 펠리클 시장으로의 산업 확대는 에프에스티 입장에서는 경쟁사가 등장한 것
하지만 아직 에프에스티를 따라가기에는 상당히 부족한 것으로 보임
에프에스티의 EUV펠리클 내구성은 이미 600W가 넘는 강한 전력을 가지고 있으며 빛의 투과율이 95%정도
EUV펠리클 가격은 2,000만원~3,000만원으로 ArF펠리클 대비 50배가 넘음
23년 11월 펠리클 CAPA 확대를 위해 284억의 신규시설투자를 공시했고 연기한 투자 완공시기가 25년 1월

에프에스티는 EUV펠리클 시제품 양산이 곧 시작될 듯함
EUV펠리클이 본격적으로 양산되기 시작한다면 장당 1,000만원으로만 가정해도 연간 1,500억의 규모의 공장이라고 하니 2,000만원을 잡으면 3,000억 규모임
23년 매출 1,430억 중 펠리클 매출이 약 825억으로 보수적으로 증설 매출 1,500억만 잡아도 펠리클 매출 2,500억수준이고 전체 매출은 3,000억으로 100% 성장 가능. 하지만 아직은 시제품 양산단계이니 온기 반영 불가 및 풀CAPA가 가동된다고 볼 수는 없음
24.12.04 신규시설투자 공시

목적: EUV용 블랭크마스크 양산 준비를 위한 시설 투자
금액 : 417억
종료 : 25년 12월 31일
세부내용
- 용인 반도체 벨트에 위치한 고객사의 요구에 신속히 대응하기 위함
- 25년 준공시점까지 대구사업장에서 대응 가능. 증가하는 시장 수요 대응을 위한 선제적 투자
이는 증설 완료된 용인 신축 공장에 장비를 도입하고 설치하기 위한 투자로 26년부터는 본격적으로 EUV용 블랭크마스크 생산이 가능할 것으로 보임

22년 EUV펠리클 양산을 위한 신규공장 신축은 24년 완공이 목표였으나 25년말로 미루어짐
최초 EUV펠리클 양산이 목적이었으나 EUV블랭크마스크와 펠리클 양산을 위한 증설 목적으로 변경 됨

25년 수요는 기존 대구공장에서 EUV블랭크 생산과 함께 펠리클 초도양산으로 대응 가능하다고 함
용인 신축공장이 완공되는 26년부터 본격적인 매출 발생이 가능할 것으로 예상됨
에스앤에스텍의 용인공장이 완공되고 양산이 될 경우 CAPA가 어느 정도 되는지 너무 궁금한데 도저히 관련된 데이터를 찾을 수가 없음(아시는 분 알려주세요 ㅠㅠ)
신사업
High-NA EUV 시대에 대응하기 위한 차세대 하드마스크 개발 완료(업체 검증 필요)
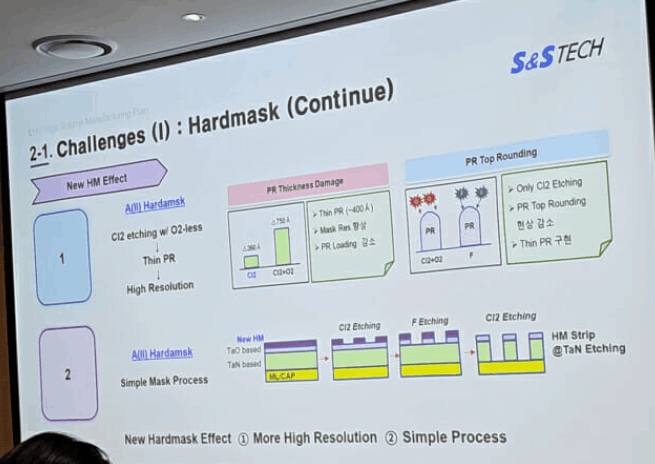
하드마스크 : 블랭크마스크의 보조격 소재. 초미세 공정에서는 PR 두께가 매우 얇아져 웨이퍼 하부층까지 식각하기가 어려운데 이 때 하드마스크를 PR 증착 전 삽입하여 웨이퍼를 보호하고 식각 성능을 향상
기존 하드마스크 소재 : 크롬, 탄탈, 실리콘 등
에스앤에스텍의 신물질 하드마스크는 기존 식각 공정이 산소와 염소 모두를 활용했던 것과 달리 염소만을 활용할 수 있도록 만듬. 이 경우 PR 도포를 더 얇게 할 수 있어 High-NA EUV 대응 가능
High-NA EUV 공정은 기존(30~60나노) EUV 공정 보다 더 얇은(10~20나노) 감광액을 도포해야함
NA는 렌즈 수치를 나타내는데 해당 수치를 높일수록 해상력이 향상됨
기존 EUV가 0.33인 반면 High-NA EUV 0.55로 더 높음
차세대 하드마스크는 식각 선택비 가 타 물질 대비 3배 가량 높고 PR 두께 감소, 마스크 제조공정 단순화 등의 이점이 있음
(하드마스크만으로 High-NA EUV에 대한 완벽한 대응은 불가. 필름 스트레스 조절, DoF(초점심도) 마진 개선 등 블랭크마스크의 주요 요소들도 함께 선응이 강화되어야 함)
리스크
25년 하반기 또는 최대 26년으로 이연되고 있는 EUV블랭크마스크 및 펠리클 실적
(하지만 중국은 반도체에 지금 엄청난 투자를 진행하고있다. 에스앤에스텍의 DUV블랭크마스크와 펠리클이 필요하다)
Disclaimer
- 당사의 모든 콘텐츠는 저작권법의 보호를 받은바, 무단 전재, 복사, 배포 등을 금합니다.
- 콘텐츠에 수록된 내용은 개인적인 견해로서, 당사 및 크리에이터는 그 정확성이나 완전성을 보장할 수 없습니다. 따라서 어떠한 경우에도 본 콘텐츠는 고객의 투자 결과에 대한 법적 책임소재에 대한 증빙 자료로 사용될 수 없습니다.
- 모든 콘텐츠는 외부의 부당한 압력이나 간섭없이 크리에이터의 의견이 반영되었음을 밝힙니다.
